博通发布3.5D XDSiP芯片封装:6000平方毫米庞然巨物
快科技12月8日消息,博通发布了全新打造的3.5D XDSiP封装平台,专门面向超高性能的AI、HPC处理器,最高支持6000平方毫米的芯片面积。这相当于大约八颗NVIDIA Blackwell架构的下一代旗舰芯片GB202,后者面积为744平方毫米。

博通发布3.5D XDSiP芯片封装:6000平方毫米庞然巨物
博通3.5D XDSiP使用了台积电的CoWoS-L封装技术,融合2.5D集成、3D封装,所以叫3.5D。它可以将3D堆栈芯片、网络与I/O芯粒、HBM内存整合在一起,构成系统级封装(SiP),最大中介层面积4719平方毫米,大约相当于光罩面积的5.5倍,还可以封装最多12颗HBM3或者HBM4高带宽内存芯片。为了达成最高性能,博通建议分别设计不同的计算芯粒,然后采用F2F面对面的方法,借助混合铜键合(HCB),将不同的芯粒堆叠在一起。
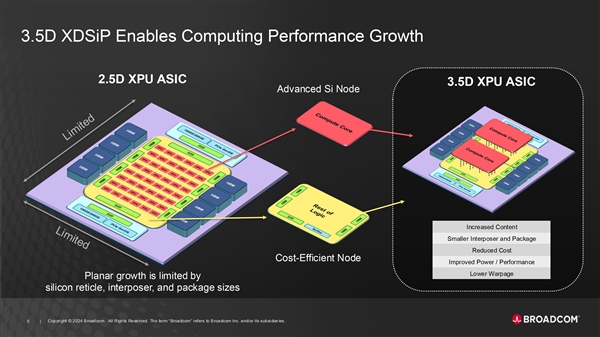
博通发布3.5D XDSiP芯片封装:6000平方毫米庞然巨物
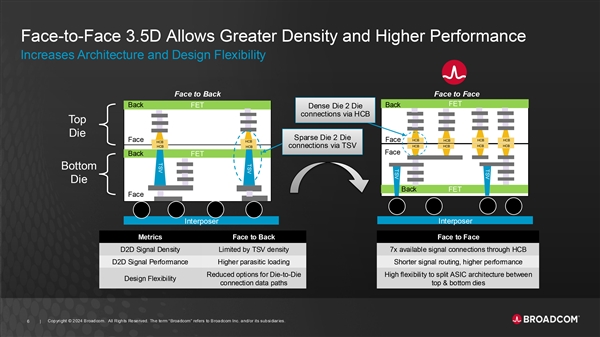
博通发布3.5D XDSiP芯片封装:6000平方毫米庞然巨物
其中的关键在于使用无凸起HCB将上层Die与底层Die堆叠在一起,不再需要TSV硅通孔。
这么做的好处非常多:信号连接数量增加大约7倍,信号走线更短,互连功耗降低最多90%,最大化降低延迟,堆叠更加灵活。

博通发布3.5D XDSiP芯片封装:6000平方毫米庞然巨物
博通计划利用3.5D XDSiP封装为Google、Meta、OpenAI等设计定制化的AI/HPC处理器、ASIC芯片,并提供丰富的IP,包括HBM PHY、PCIe、GbE甚至是全套芯粒方案、硅光子技术。这样一来,客户可以专心设计其处理器的最核心部分,即处理单元架构,无需考虑外围IP和封装。博通预计首款产品将在2026年推出。
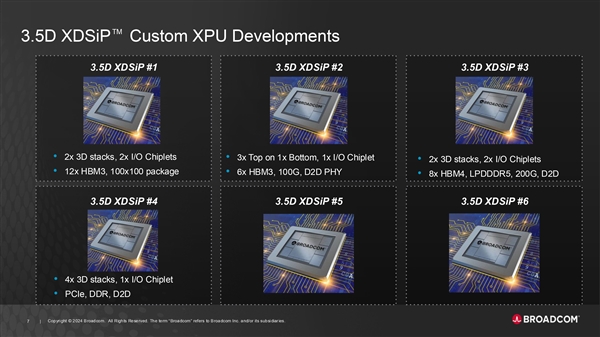
博通发布3.5D XDSiP芯片封装:6000平方毫米庞然巨物
【本文结束】出处:快科技
相关文章
- 高通骁龙8 Elite Gen6 Pro特调版偷跑:采用2nm工艺 三星独占
- 总投资6亿元!灿瑞科技全球芯片研发中心项目封顶
- 显卡也疯狂!1年前1.7万买的RTX 5090:现在涨至3.4万
- 没有三星放心吧!骁龙8 Elite Gen 6系列都是台积电N2P工艺
- 40%产能要转移到美国 台积电被逼变成美积电:专家回应
- 苹果仅用5年就追上AMD!M系列芯片市占率已逼近20%
- 联发科天玑9500s发布:4超大核+4大核设计 同档最强Soc
- 新一代中端神U!联发科天玑8500发布:跑分突破240万、GPU性能大涨25%
- MiniLED背光技术2.0时代来了 RGB架构电视今年冲击40万台
- AI抢芯大战白热化!云厂商溢价60%扫货存储芯片:手机厂商被迫涨价


